

芯片封裝揭秘!激光植球技術(shù)在LGA和BGA的不同應(yīng)用
芯片封裝揭秘!激光植球技術(shù)在LGA和BGA的不同應(yīng)用
在當(dāng)今電子設(shè)備追求輕薄短小的趨勢(shì)下,芯片封裝技術(shù)的重要性日益凸顯。作為兩種主流的封裝方式,LGA和BGA各有特點(diǎn),而新興的激光錫球焊接技術(shù)正在為封裝工藝帶來革命性的變化。本文將深入解析LGA與BGA的區(qū)別,并探討激光錫球焊接技術(shù)如何提升芯片封裝的效率與質(zhì)量。

LGA與BGA:芯片封裝的兩種面孔
什么是BGA封裝?
BGA(球柵陣列)是一種用于集成電路的表面貼裝封裝技術(shù)。它的底部整齊排列著一個(gè)個(gè)微小的錫球,這些錫球充當(dāng)了芯片與印刷電路板(PCB)之間的電氣連接媒介。

BGA的優(yōu)勢(shì):
高密度互連:BGA允許在有限空間內(nèi)布置大量引腳,完美應(yīng)對(duì)現(xiàn)代芯片高密度連接的需求。
優(yōu)異的熱傳導(dǎo)性:BGA錫球與電路板之間的導(dǎo)熱性能良好,能有效將芯片內(nèi)部產(chǎn)生的熱量傳遞到電路板,避免IC過熱。
低電感特性:與普通引腳相比,BGA的錫球形狀短小,減少了不必要的電感,有助于防止高速電路中的信號(hào)失真。
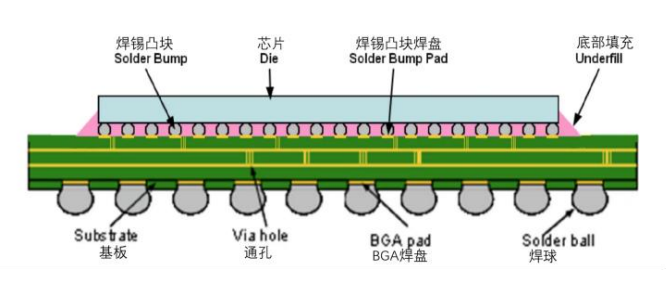
BGA的局限性:
機(jī)械應(yīng)力敏感:錫球的形狀導(dǎo)致其延展性不足,當(dāng)芯片與電路板因熱膨脹系數(shù)不同而發(fā)生不同步彎曲時(shí),焊點(diǎn)容易斷裂。
檢測(cè)困難:焊接完成后,被元件本體遮蓋的焊點(diǎn)不易檢查,通常需要昂貴的X光機(jī)或CT掃描儀來保證焊接質(zhì)量。
調(diào)試不便:開發(fā)初期需要臨時(shí)連接封裝和電路時(shí),錫球形狀不易附著,需要特殊插座才能實(shí)現(xiàn)穩(wěn)定連接。
什么是LGA封裝?
LGA(平面網(wǎng)格陣列)與BGA類似,也是一種面積陣列封裝組件,但底部沒有預(yù)植的錫球,而是平坦的金屬觸點(diǎn)。這些觸點(diǎn)直接與主板上的插槽接觸,或者通過焊接與電路板連接。

LGA的優(yōu)勢(shì):
穩(wěn)定的電氣連接:提供穩(wěn)定的電氣連接和機(jī)械穩(wěn)定性,避免了引腳歪斜、短路和開路的問題。
維護(hù)便捷:如果使用插座連接,更換IC時(shí)無需拆焊,只需松開插座即可取出壞掉的芯片。
靈活的連接方式:LGA既可以通過專用插座連接,也可以通過普通焊接方式連接到PCB上,為電路板布局提供了更多選擇。
LGA的局限性:
焊接風(fēng)險(xiǎn):如果選擇焊接方式連接LGA,由于其引腳高度較低,焊接后容易出現(xiàn)空孔和錫珠,影響連接質(zhì)量。
激光錫球焊接技術(shù):封裝工藝的革新者
傳統(tǒng)植球工藝的挑戰(zhàn)
傳統(tǒng)的植球方法主要包括電鍍、印刷錫膏固化和植球三種方式。電鍍方式存在工藝復(fù)雜、成本高、制造周期長(zhǎng)和環(huán)境污染等問題;而印刷錫膏方式則不容易控制凸點(diǎn)高度,難以制作小于200μm的凸點(diǎn)。

激光錫球焊接的工作原理
激光錫球焊接是一種新型的無助焊劑錫球附著工藝。它通過激光瞬間加熱錫球,使錫球熔化并精準(zhǔn)噴射到焊接處。在芯片封裝的精微世界,BGA/LGA植球工藝至關(guān)重要。紫宸激光錫球焊接機(jī),以創(chuàng)新激光技術(shù)攻克傳統(tǒng)植球難題。設(shè)備核心由運(yùn)動(dòng)平臺(tái)、植球機(jī)構(gòu)、定位相機(jī)、激光器、工控機(jī)及外光路系統(tǒng)組成。實(shí)現(xiàn)±5μm的超高精度焊接,輕松處理0.06-1.2mm錫球。焊接頭內(nèi)置在植球機(jī)構(gòu)模組中,與噴球腔體同軸置于升降軸上,通過高精度定位相機(jī)確保植球位置的準(zhǔn)確性。
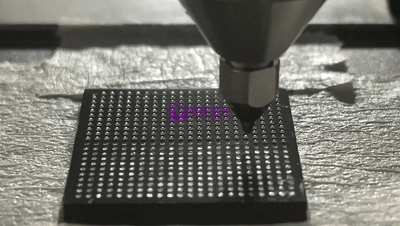
激光植球技術(shù)的顯著優(yōu)勢(shì)
無助焊劑工藝:錫球內(nèi)不含助焊劑,不會(huì)造成飛濺,避免了助焊劑殘留對(duì)封裝和器件的污染腐蝕。
精確的熱控制:工藝無需整體加熱,僅局部瞬間加熱,對(duì)周邊元件熱影響小,特別適合熱敏感器件。
卓越的工藝精度:可兼容0.06mm~1.2mm規(guī)格的錫球,植球速度可達(dá)3-5點(diǎn)/秒。
一致性高:因錫量恒定,凸點(diǎn)錫量穩(wěn)定、一致性好。
環(huán)保高效:無需后續(xù)清洗工序,可實(shí)現(xiàn)零污染生產(chǎn),更符合綠色制造理念。

激光錫球焊接在LGA與BGA封裝中的應(yīng)用
在BGA封裝中的應(yīng)用
激光錫球焊接技術(shù)直接適用于BGA封裝的制造過程,特別是在晶圓級(jí)芯片凸點(diǎn)制作環(huán)節(jié)。隨著電子元器件的精、薄、短、小、差異化發(fā)展,傳統(tǒng)工藝已無法滿足超細(xì)小化、多層化的點(diǎn)狀零件焊接需求。

激光植球方式特別適合BGA封裝中的高密度、細(xì)間距應(yīng)用,如高清攝像頭模組及精密聲控器件、數(shù)據(jù)線焊點(diǎn)組裝等細(xì)小焊盤。
在LGA封裝中的應(yīng)用
對(duì)于LGA封裝,雖然搜索結(jié)果未明確提及激光錫球焊接的直接應(yīng)用,但考慮到LGA本質(zhì)上是一種沒有預(yù)植錫球的BGA變體,激光錫球焊接技術(shù)同樣可以在LGA制造過程中發(fā)揮作用。
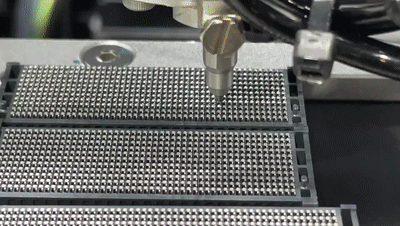
特別是在需要將LGA直接焊接到PCB上的應(yīng)用場(chǎng)景,激光錫球焊接可以提供更精確、更可靠的連接解決方案。
激光錫球焊接技術(shù)的市場(chǎng)前景
激光錫球焊接技術(shù)在國(guó)內(nèi)國(guó)外都有不同程度的發(fā)展,盡管經(jīng)過這些年的發(fā)展,始終沒有大的跨越和應(yīng)用拓展。然而市場(chǎng)需求不斷變化,不但存在縱向數(shù)量的增長(zhǎng),而且橫向的應(yīng)用領(lǐng)域也在不斷的擴(kuò)展,以電子數(shù)碼類產(chǎn)品相關(guān)零部件錫焊工藝需求為主導(dǎo),涵蓋汽車電子、光學(xué)元器件、聲學(xué)元器件等多個(gè)行業(yè)。
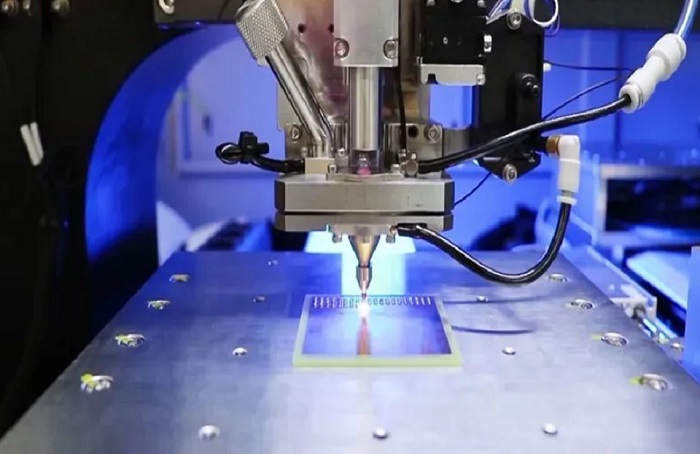
有專家預(yù)測(cè),激光錫焊在目前及未來很長(zhǎng)的時(shí)間將會(huì)有驚人的爆發(fā)式增長(zhǎng)和較為龐大的市場(chǎng)體量。
結(jié)語(yǔ)
LGA和BGA作為兩種主流的芯片封裝技術(shù),各有其適用的場(chǎng)景和優(yōu)勢(shì)。BGA適合高密度、高性能的應(yīng)用,而LGA則在可維護(hù)性和機(jī)械穩(wěn)定性方面表現(xiàn)更佳。無論是BGA高密度植球還是LGA精密焊接,紫宸激光的植球設(shè)備均表現(xiàn)卓越,速度高達(dá)5點(diǎn)/秒,良率超99.98%,助力您大幅提升生產(chǎn)效率與產(chǎn)品可靠性。

隨著激光錫球焊接技術(shù)的成熟與發(fā)展,它正在為芯片封裝工藝帶來新的可能,特別是在高密度、細(xì)間距應(yīng)用場(chǎng)景中,這種無助焊劑、高精度的焊接方式將發(fā)揮越來越重要的作用。對(duì)于電子制造企業(yè)而言,了解并采納這種先進(jìn)的焊接技術(shù),無疑將在未來的市場(chǎng)競(jìng)爭(zhēng)中占據(jù)先機(jī)。




 瀏覽器自帶分享功能也很好用哦~
瀏覽器自帶分享功能也很好用哦~